
一、琼中扫描电镜(SEM)在半导体失效分析中的电学功能应用
(一)电压衬度分析与缺陷定位
通过二次电子信号差异识别样品表面电势分布,可精准定位以下失效模式:
开路/短路故障:金属互连层断裂(电压衬度差>50%)或层间短路(电压衬度差<5%)
PN结异常:漏电流路径(反向偏压下衬度异常区域直径≈1μm)
接触电阻失效:金属-半导体界面接触不良(衬度突变区域对应接触电阻>100Ω)
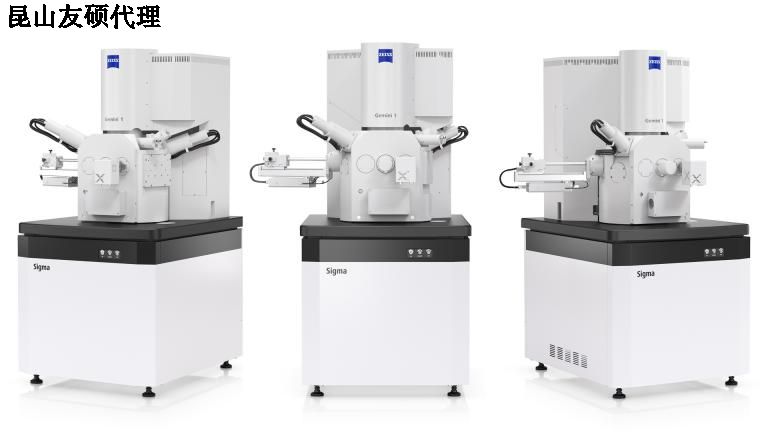
(二)束感生电流(EBIC)技术
利用电子束激发载流子,实现半导体器件内部特性的无损检测:
耗尽层测量:测定PN结宽度(误差<5nm),定位结区缺陷
少子寿命分析:通过EBIC信号衰减速率计算载流子寿命(分辨率达ps级)
沟道效应检测:识别MOSFET沟道长度偏差(检测灵敏度达0.1nm)
(三)元素分析与污染检测
结合能谱仪(EDS)实现:
textCopy Code表面污染物成分分析 → 金属离子迁移路径重建 → 失效根源判定
典型应用场景:
硅片表面金属污染(如Cu含量>10^12 atoms/cm²)导致漏电流增大
钝化层Al离子扩散引发栅氧击穿(Al/Si原子比异常>0.05)
二、原子力显微镜(AFM)在半导体失效分析中的电学功能拓展
(一)导电原子力显微术(C-AFM)
通过探针施加偏压(0.1-10V)测量局部电学特性:
纳米级电流成像:定位栅氧击穿点(漏电流>1nA/μm²)
隧道电流分析:评估介电层完整性(隧穿电流突变对应厚度偏差>0.2nm)
导电通道可视化:显示RRAM阻变存储器细丝形成过程(直径≈10nm)
(二)扫描电容显微术(SCM)
测量局域载流子浓度分布(灵敏度达10^15 cm^-3):
掺杂浓度检测:识别离子注入不均匀区域(浓度波动>20%)
界面态分析:测量SiO2/Si界面陷阱密度(精度达10^10 cm^-2·eV^-1)
二维载流子成像:绘制FinFET沟道载流子分布图(空间分辨率5nm)
(三)表面电势测量(KPFM)
通过探针-样品间接触电势差成像:
功函数测绘:识别金属栅极材料缺陷(电势偏差>50mV)
界面电荷分析:检测高k介质层固定电荷密度(灵敏度0.1e/nm²)
电势动态监控:记录器件工作状态下电势波动(时间分辨率1ms)
三、SEM与AFM技术对比
四、典型联合分析案例
案例:28nm CMOS器件栅氧击穿失效分析
SEM-EDS检测:
定位击穿点(直径≈50nm)
检测Al元素异常扩散(Al/Si原子比达0.08)
AFM-C-AFM验证:
测量击穿点漏电流密度(3.2mA/μm²)
绘制击穿路径三维形貌(深度≈2nm)
AFM-KPFM补充:
发现界面电势异常(ΔΦ=120mV)
确认固定电荷聚集(密度2.5×10^12 cm^-2)
该技术方案通过多尺度电学表征(SEM宏观定位 → AFM纳米级精测),实现失效机理的完整溯源










